管式爐中臭氧對 SiC / GaN 等寬禁帶半導體的氧化處理方法
適用領域:功率半導體工藝開發、界面鈍化、器件可靠性與穩定性研究
一、工藝目標與應用背景
在 SiC、GaN 等寬禁帶半導體材料表面,通過受控臭氧(O?)氧化處理,實現以下目標:
?在低于傳統熱氧化溫度條件下,形成薄且均勻的表面氧化層
?修復材料表面的 碳空位(SiC)或氮空位(GaN)
?降低表面態與界面陷阱密度(Dit)
?改善 MOS 結構或 MIS 結構的 界面電學特性
?提升功率器件在高溫、高電場下的長期可靠性
該方法常用于:
?SiC MOSFET 柵氧化前處理
?GaN MIS-HEMT 柵介質界面鈍化
?外延片表面缺陷修復
?后道封裝前表面穩定化處理
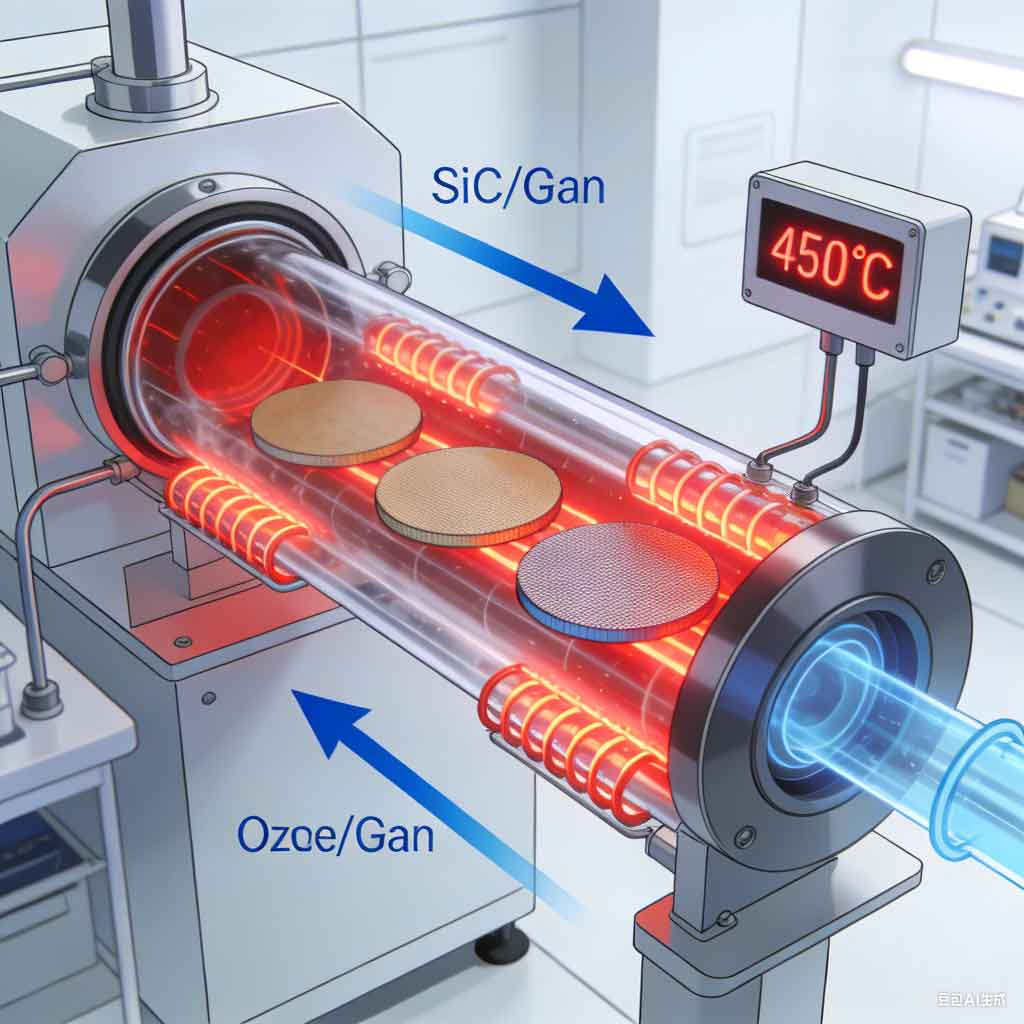
二、臭氧氧化的機理與技術挑戰
1. 作用機理
臭氧是一種強氧化性氣體,其分解產生的高活性原子氧(O*)在較低溫度下即可參與反應:
?SiC 表面
?優先氧化 Si,生成 SiO?
?有助于清除殘余碳團簇或 C-rich 層
?降低 SiO? / SiC 界面態密度
?GaN 表面
?填補 N 空位,抑制表面漏電
?形成超薄 Ga–O 過渡層,有利于后續 ALD 介質沉積
相比 O? 或濕氧,O? 可在 300–600 °C 范圍內實現有效氧化,避免高溫退火帶來的應力和晶格損傷。
2. 關鍵挑戰
?氧化過強 → 生成非理想亞氧化物(如 SiO?C?、GaO?)
?氧化層應力過大 → 界面缺陷反而增加
?O? 濃度與處理時間窗口較窄,重復性要求高
?管式爐內流場與樣品位置對均勻性影響明顯
因此,精確控制臭氧濃度、溫度和處理方式(連續 / 脈沖)是工藝成功的關鍵。
三、典型工藝參數建議(示例)
> 以下參數為實驗與文獻中常用區間,需根據材料類型、器件結構進行微調。
| 參數 | 推薦范圍 |
|---|---|
| 基底材料 | 4H-SiC、6H-SiC、GaN-on-Si / SiC |
| 管式爐溫度 | 300–600 °C |
| 臭氧濃度 | 200–2000 ppm(氣相)推薦M1000臭氧發生器 |
| 載氣 | N? 或 O?(高純) |
| 總氣體流量 | 0.5–2.0 slm |
| 處理時間 | 5–15 min |
| 處理方式 | 連續或脈沖式 O? |
| 管內壓力 | 常壓或微正壓 |
建議初始工藝:
> 450 °C / 500 ppm O? / N? 載氣 / 10 min / 脈沖模式

四、管式爐臭氧氧化工藝流程(詳細步驟)
步驟 1:樣品前處理與裝載
1. 使用標準清洗流程(如 RCA 或溶劑清洗)去除有機污染
2. DI 水充分漂洗
3. N? 槍吹干或 120 °C 熱板烘干 5 min
4. 將樣品水平放置于石英舟或 Al?O? 樣品架上
5. 裝入管式爐恒溫區中心位置
> ?? 避免樣品重疊,確保臭氧氣流可充分接觸表面。
步驟 2:系統吹掃與升溫
1. 關閉臭氧,通入高純 N?
2. 吹掃管腔 ≥10 min,排除空氣與殘余水汽
3. 以 5–10 °C/min 速率升溫至目標工藝溫度
4. 溫度穩定后保持 N? 流動 3–5 min
步驟 3:臭氧氧化處理(核心步驟)
連續模式:
?切換氣路,引入設定濃度 O?
?保持穩定處理 5–15 min
脈沖模式(推薦):
?O? ON:5–30 s
?N? purge:30–60 s
?循環 5–20 次
> 脈沖方式可有效:
?降低界面應力
?抑制過度氧化
?提高工藝可重復性
步驟 4:吹掃冷卻與取樣
1. 停止臭氧供給
2. 通入 N? 吹掃 ≥10 min
3. 隨爐自然冷卻至 <100 °C
4. 取出樣品,置于潔凈容器中待測
五、氧化效果表征與評估要點
1. XPS(X 射線光電子能譜)
?分析 Si–O、Ga–O 鍵比例
?判斷亞氧化物與界面層厚度
?評估 C / N 空位修復效果
2. PL(光致發光)
?表面復合中心強度變化
?缺陷相關發光峰是否減弱
3. 電學測試(CV / EIS / I–V)
?接口陷阱密度(Dit)
?漏電流變化
?閾值電壓穩定性
六、工藝注意事項與安全提示
1. 臭氧為強氧化性氣體,必須配備尾氣分解裝置
2. 管式爐密封性需良好,避免 O? 泄漏
3. 禁止與有機材料、橡膠長時間接觸
4. 初次工藝應從低濃度、短時間開始摸索窗口
5. 建議每次實驗記錄:溫度、濃度、流量、樣品位置
七、小結
管式爐中引入臭氧進行 SiC / GaN 表面氧化,是一種低溫、可控、兼顧界面質量與器件可靠性的有效工藝手段。通過合理設計臭氧濃度、溫度及脈沖策略,可顯著改善寬禁帶半導體的界面與電學性能,為高可靠性功率器件制造提供重要支撐。